アプリケーションノートAP8160
この解説は、H2 (または銅箔がプリプレグにプレスされる高さ) が Polar フィールドソルバーでどのように定義されているかを説明するのに役立ち、「銅箔の厚さ T1 を H2 のパラメータに追加すべきかどうか」という質問を理解するのに役立ちます。これに対する答えを理解するには – 以下を読み進めてください…
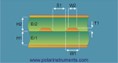
図1 Edge-coupled offset stripline構造
上図のedge-coupled stripline構造を注意深く見ると、銅箔トレースが周囲のH2誘電体材料に囲まれている(埋め込まれている)ことがわかります。Polarフィールドソルバーのシミュレーション構造がこのような誘電体材料に埋もれた伝送線路トレースをシミュレーションする場合、H2厚にプリプレグ材料にプレスされた銅箔トレースも含まれています。H1は、コア材料(両面に積層された銅箔層を持ち、出荷時点で完全に硬化しているPCB基板材料)を表しており、この材料は販売されている時点で変化の無い材料厚を持ち、 その値はデータシートに明記されています。H2によって示される高さは、ガラス繊維強化物(プリプレグ)と部分的に硬化したエポキシであるプリプレグ(プリプレグ)の2つから構成される材料であるため、データシート上の厚のみから計算することはできません – 加熱およびプレスすると、これはエッチングされた銅箔トレースの周囲を流れ、H2の仕上厚の値は層上の伝送線路トレースの銅箔カバー率と、製造工程で加熱されたときの樹脂の流動特性によって仕上厚の厚みが変化します。
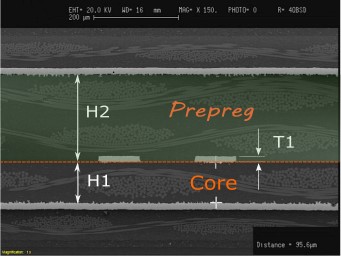
図2 edge-coupled striplineのマイクロセクション断面
図2では、図1の図形化された図面ではなく、実際の材料の断面に置き換えられたものです、このH2例の部分は2枚のプリプレグが重ね合わされて使用されています。このサンプルのプリプレグは、プレス工程後のすでに硬化した状態のPCBのマイクロセクション断面です。H1の厚みは、図 1 で説明したように、材料メーカーのデータシートに記載された値をそのまま使用できます。H2の厚に関しては、プリプレグの樹脂成分が銅箔トレース間の隙間などのスペースに流れ込んだ後のプレス仕上げ工程後の厚さになります。これについて考えてみましょう – H2の値は、銅箔カバー率が高いほど大きくなり、銅箔カバー率が低いと小さくなります。図をごちゃごちゃにしないために省略されたパラメータ(アイソレーション距離)は、H2の値からT1の値を引いたものです。H2は、マイクロセクション分析の際に距離測定しやすい部分です。しかし、シミュレーションするためにH2の値を予測するには、基板設計者の知識が必要です。

図3:わかりやすくするために図1と図2の合成した比較です
さて本題に戻ると、H2の値をシミュレーションでどのように設定して計算するかでした。上記から、あなたはこのように思いませんか? “重ねられたプリプレグの総厚は…”基本的には、それぞれのプリプレグの厚さを足した値から、パネルの端からの樹脂流れの量を差し引いたものに、銅箔厚を銅箔カバー率に応じた量で加えたもの。PCB製作者なら、経験に基づき製造プロセスに関するこの値に関して大まかな予想が出来ます。Polar instruments社のSpeedstack PCBやSpeedstack Siなどの層構成設計ツールには、H2の厚またはプリプレグ層のプレス後の厚さを推測するためのさまざまな方法のアルゴリズムが組み込まれています。これらは銅カバー率値の有無にかかわらず機能しますが、層あたりの銅カバー率の設定がある場合は、プレス厚のより正確なシミュレーションが可能になります。シミュレーションの観点からは、オペレータ(またはPolar Speedstack)が決めたH2の値をベースにインピーダンスパラメータを処理します。そしてマイクロセクション分析は、「製造後の厚さを、シミュレーションの想定通りに製造した」ことを証明するために必要な工程です
まとめ
1. H2の値は単純に、プリプレグカタログ厚(1枚目)+プリプレグカタログ厚(2枚目)+銅箔厚(T1)とはならない
2. プレス工程の樹脂流れでの減、銅箔カバー率などの影響で変わってくる
3. H2厚の値を精確に出すには、基板設計者の経験に基づくか、または層構成設計ツールのアルゴリズムを使う
4. H2の厚みが予測通りか確認するには、マイクロセクション分析して確認するしかない
